 来源:壹芯微 发布日期
2019-09-28 浏览:-
来源:壹芯微 发布日期
2019-09-28 浏览:-GBT和二极管性能的下一次飞跃
未来一代IGBT模块将采用增强型沟道ET-IGBT和场充电提取(FCE)二极管,能够提供更高水平的电气性能,包括低损耗、良好的可控性、高耐用性和软二极管反向恢复等方面。
尽管,过去二十年绝缘栅双极晶体管(IGBT)和反并联二极管已经经历了重大突破,相对于导致器件整体性能明显飞跃的器件工艺和设计理念,进一步开发工作正在进行中,为的是实现新水平的更高功率密度、更好的操控性和耐用性。在这篇文章中,我们首先将简要地讨论目前IGBT和二极管的发展趋势,同时专注于下一代技术;即增强型沟道IGBT(ET-IGBT)和场充电提取(Field Charge Extraction,FCE)二极管。然后,将展示新的器件概念和它们在3.3 kV电压等级的电性能。
IGBT和二极管的未来发展趋势
目前,IGBT的三个主要发展趋势都瞄准(a)增强型沟道ET-IGBT的更高功率密度,(b)高于传统125℃的更高的工作温度,和(c)IGBT/二极管集成解决方案,被称为反向导通RCIGBT或双模式绝缘栅晶体管(BIGT)。在BIGT情况下,单个芯片方法提供了改进的性能,尤其是对由于取决于给定应用要求的可用二极管面积的限制。然而,传统IGBT/二极管双芯片方法仍然是许多主流应用的重要发展路径。如今,具有相似损耗性能的最先进的高电压器件,在软穿通(SPT)结构中采用了增强型平面IGBT(EP-IGBT)或沟道IGBT MOS单元概念。然而,对于低于2 kV的额定值来说,除了沟道IGBT,先进ET-IGBT已经是一个成熟的技术。此外,ET-IGBT概念也能够为高压IGBT提供下一个步骤的损耗减少。图1展示了一个3300 V IGBT的导通状态Vce(sat)损耗的减少,相当于在相同体积SPT平台上用新的ET-IGBT MOS单元实现了相同关断损耗(Eoff)。然而,必须指出的是,基于沟道的IGBT,特别是对较高额定电压,相对于可导致IGBT导通期间最佳开关性能不太可控的基于平面的器件,它表现出一种固有的高有效栅极输入电容。克服了这种不利方面,结合ET-IGBT的更低损耗,将为下一代高电压IGBT提供理想的解决方案。
对于快速二极管器件,损耗和反向恢复软度仍然是匹配新的ET-IGBT性能的关键性能指标。场充电提取(FCE)概念表明,极端开关条件下的软恢复性能加上低损耗都可以实现,同时对其他电气参数没有影响。
图1:3.3kV IGBT通态压降和关断损耗之间的权衡曲线。增强型沟道(ET)和增强型平面(EP)结构的比较。
ET-IGBT概念
为了降低损耗,实现针对沟道发射极附近靶向增强载流子浓度的ET-IGBT概念所遵循的主要方法,基于有n增强层的条纹(striped)有源沟道MOS单元的引入。为了减少有效输入电容来提高开关可控性,重点是有源单元之间区域的优化,这大大提高了开关期间的器件有效输入电容值。通过消除有源单元之间的栅区,如图2中横截面所示,相比最先进沟道IGBT设计,我们实现了一个低有效栅极发射输入电容,同时提供了最佳的反向阻断能力。相比EP-IGBT所产生的额定电流,3.3 kV ET-IGBT较低的导通状态损耗提供了增加额定电流20%的能力。
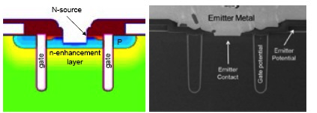
图2:ET-IGBT MOS单元概念。
图3:组合的FCE和FSA概念(a)和(b)横截面,(c)掺杂分布.
FCE二极管概念
对于新的二极管,与现有设计相比,采用了场充电提取(FCE)概念和成熟的场屏蔽阳极(FSA)设计的组合,如图3所示。n基极的厚度对于整体损耗的产生起着关键作用,其中的低损耗二极管需要一个薄n基极设计。然而,n基极区域厚度的进一步削减通常受限于所得到的二极管的瞬间反向恢复行为。通过在二极管的阴极侧引入小p掺杂区域(如图3),在恢复阶段实现了一个场致载流子注入过程,这将生成固有的软二极管。因此,3.3 kV额定二极管的n基极可以减薄10%,同时通过增加电阻率来保持阻断能力,而不损害软反向恢复。这种方法的好处是改善了20%技术曲线。此外,由于反向恢复期间没有大过冲电压,这些固有的软二极管鲁棒性得到了改善。
3.3 kV ET-IGBT模块原型
3.3 kV ET-IGBT和FCE二极管芯片是用约1平方厘米的有源区域制造的,每个IGBT芯片都有75 A的定义额定值,二极管为150 A。芯片被用在标准高电压绝缘模块(140×70平方毫米)中,采用如图4所示的双配置。双封装中每个IGBT/二极管器件都包括4×ETIGBT和2×FCE二极管的单衬底。模块所产生的电流额定值为300 A,而如今的等效EP-IGBT为250 A。
图4:在25℃和150℃时,300A/3.3kV ET-IGBT模块输出IV特性。
模块在静态和动态条件下进行了电性测试。图4示出了ET-IGBT在25℃和150℃的导通状态特性,并与EP-IGBT进行了比较。ET-IGBT模块显示出比EP-IGBT低非常多的静态损耗,以及芯片安全并联的强大正温度系数。在300 A额定电流下,150℃ ET-IGBT设计有2.75 V的Vce(sat),EP-IGBT则为3.55 V。
图5分别示出了ET-IGBT和参考EP-IGBT的标称关断和导通开关波形。试验条件保持相同,以更好地评估器件的性能。在150℃下,这些器件在施加的1800 V DC链路电压和300 A额定电流下进行开关,栅极发射极电容为47 nF。杂散电感为600 nH,关断栅极电阻为9Ω,而每个设计的导通栅极电阻有所不同。ET-IGBT的关断损耗(Eoff)约在650mJ,EP-IGBT则为600mJ。但是,得到的导通损耗(Eon)变化较大,尽管有不同的栅极电阻,其ET-IGBT是在860 mJ,EP-IGBT为910 mJ。所有测试器件的总开关损耗大致都在同一水平,略低于1.5 J。FCE二极管反向恢复性能也可以在IGBT导通波形中看出。针对栅极电阻的变化绘制的导通参数(Icmax、Eon和di/dt)的ET-IGBT可控性示于图6。
图5:300A/3.3kV模块关断(左)和导通(右)波形(1800V,300A,150℃)。
图6:改变导通参数(1800V,300A,150℃)栅极电阻的影响。
FCE二极管柔软度也根据同样的电路设置进行了测试,但在临界柔软度条件下有15 A的较低电流和25℃的较低温度,如图7所示。FCE二极管清楚地显示了在这些极端条件下相比标准二极管非常软的恢复性能,出现了一个典型电流阶跃(snap-off)以及相关高电压过冲。
ET-IGBT关断和短路SOA性能
在高电流和电压条件下测试了两个并联芯片的关断(RBSOA)行为。对于RBSOA,ETIGBT针对2500 V的高DC链路电压进行了测试,在25℃和125℃下,最大达到的开关电流是额定电流的约5倍和4倍,分别如图8所示。在25℃下,器件进入并承受称为动态雪崩和开关自钳位模式(SSCM)的应力条件。在125℃温度下,由于较高水平的载流子浓度,器件如期经历了更强的动态雪崩,这导致了一个较低但仍然足以关断的能力。
壹芯微科技针对二三极管,MOS管作出了良好的性能测试,应用各大领域,如果您有遇到什么需要帮助解决的,可以点击右边的工程师,或者点击销售经理给您精准的报价以及产品介绍
工厂地址:安徽省六安市金寨产业园区
深圳办事处地址:深圳市福田区宝华大厦A1428
中山办事处地址:中山市古镇长安灯饰配件城C栋11卡
杭州办事处:杭州市西湖区文三西路118号杭州电子商务大厦6层B座
电话:13534146615
企业QQ:2881579535

深圳市壹芯微科技有限公司 版权所有 | 备案号:粤ICP备2020121154号