 来源:壹芯微 发布日期
2019-09-25 浏览:-
来源:壹芯微 发布日期
2019-09-25 浏览:-半桥、全桥和LLC的电源系统以及电机控制系统的主功率MOSFET、同步Buck变换器的续流开关管、以及次级同步整流开关管,其体内寄生的二极管都会经历反向电流恢复的过程。功率MOSFET的体二极管的反向恢复性能和快恢复二极管及肖特基二极管相比,其反向恢复速度要低很多,反向恢复电荷也要大很多,因此反向恢复的特性较差。这样,导致二极管的开关损耗增加,降低系统的效率,同时,也会产生较高的振铃,影响功率MOSFET的安全工作 。功率MOSFET数据表中,通常给出了一定条件下的Qrr和反向恢复的时间,并没有给出和实际应用相关的、在不同的起始电流和不同的电流下降斜率下,对应的反向恢复特性,本文就讨论这些问题并做详细的分析。
MOSFET的结构及反向恢复波形分析
沟槽Trench型N沟道增强型功率MOSFET的结构如图1所示,在N-epi外延层上扩散形成P基区,然后通过刻蚀技术形成深度超过P基区的沟槽,在沟槽壁上热氧化生成栅氧化层,再用多晶硅填充沟槽,利用自对准工艺形成N+源区,背面的N+substrate为漏区,在栅极加上一定正电压后,沟槽壁侧的P基区反型,形成垂直沟道。由图1中的结构可以看到,P基区和N-epi形成了一个PN结,即MOSFET的寄生体二极管。
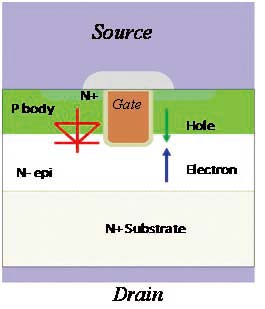
图1 MOSFET内部结构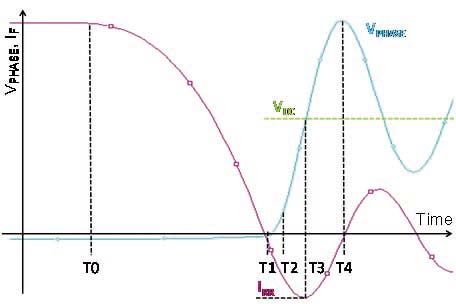
图2 反向恢复波形
当体二极管外加正向电压VF时,正向电压削弱了PN结的内电场,漂移运动被削弱,扩散运动被增强,扩散和漂移的动态平衡被破坏。结果造成P区的空穴(多子)流向N区,N区的电子(多子)流向P区,如图1中箭头所示。进入P区的电子和进入N区的空穴分别成为该区的少子。因此,在P区和N区的少子比无外加电压时多,这些多出来的少子称为非平衡少子。这些非平衡少子,依靠积累时浓度差在N区和P区进行扩散。空穴在N区扩散过程中,同N区中的多子电子相遇而复合,距离PN结边界越远,复合掉的空穴就越多。通常把正向导通时,非平衡少数载流子积累的现象叫做电荷存储效应。
当体二极管施加反向电压时,P区存储的电子和N区存储的空穴不会马上消失,它们将通过两个途径逐渐减少:
a. 在反向电场作用下,P区电子被拉回N区,N区空穴被拉回P区,形成反向漂移电流;
b. 与多数载流子复合。
通过图2可以很好地说明整个反向恢复的过程。
a. T0~T1阶段,PN结处于正向偏置,即势垒区仍然很窄,PN结的电阻很小,二极管的正向电流以一固定的di/dt逐渐减小,di/dt的大小由外电路决定;
b. T1~T2阶段,二极管的存储电荷在反向电压的作用下开始扫出,但PN结仍未形成耗尽层,反向电流由扫出的过量电荷维持。因此二极管不能承受反向电压,电流仍以di/dt速率下降;
c. T2~T3阶段,PN结处等离子浓度衰减为0,即在PN结处形成耗尽层,PN结开始承受反向电压。由于二极管反向电压的上升,导致了反向恢复电流的di/dt逐渐减小;在T3时刻,二极管电压达到VDC,di/dt降到0,扫出电流达到最大值,即IRR;
d. T3~T4阶段,反向电流由从等离子区扩散到耗尽层的载流子维持,由于等离子的持续耗散,在空间电荷区的边缘过量电荷浓度的梯度逐渐减小,导致T3后的反向电流将减小。由于负di/dt的存在,二极管上的反向电压将会出现超调,当电流降为0时,反向电压将会达到最大值。T4之后,回路进入了RLC自由振荡阶段。
反向恢复中的di/dt分析

图3 反向恢复仿真电路
由于di/dt直接影响了反向恢复电流IRR的大小,因此分析di/dt的变化对实际应用将会很有意义。为分析影响di/dt大小的因素,设计了图3所示的电路。其中U2为被测器件,U1为开关管,为电感提供电流以及为U2提供反向电压,L1为线路的寄生电感,L2为负载电感,用来提供正向电流IF。
电路工作过程如下,当U1导通时,电感L2的电流上升,其峰值电流为,当U1关断时,L2的电流经U2的体二极管续流,此电流即为二极管的正向导通电流IF。当U1再次打开时,VDC通过L1、U1施加正向电压于U2的体二极管,使其进入反向恢复阶段。
1 T2时刻之前的di/dt分析
在T2时刻之前,U2的体二极管反向导通电阻很小,可以忽略不计,因此根据回路的KVL方程可得
(1)
由式(1)可知,di/dt由三个因素决定,即VDC,VDS(U1),L1。VDC越高,VDS(U1)、L1越小,di/dt就越大。下面通过三个试验来研究di/dt的变化情况。
试验1:改变寄生电感
由于回路的寄生电感L1改变比较困难,所以通过仿真的方法来验证di/dt的变化情况。图4为L1为不同电感值的仿真结果,可以看到,电感值越小,di/dt越大,反向恢复电流IRR也越大。
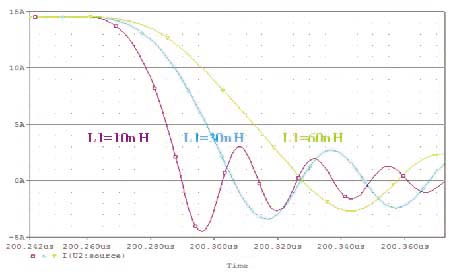
图4 不同L1的反向恢复仿真波形
试验2:改变U1的开通速度
通过控制U1的栅极电容C1来改变U1的开通速度同样也可以改变电流变化率di/dt,这是因为U1的开关速度改变了VDS(U1)的变化率。图5为改变栅极电容的实际测试结果,可以看到随着Cgs的减小,U1的开通速度变快,di/dt变大,反向恢复电流IRR也会变大。但U1的开关速度对di/dt的影响是有限的,因为VDS(U1)对di/dt的影响仅仅是在U1的开通期间(即di/dt变化的初期),当U1完全开通后,di/dt仅由回路的寄生电感L1决定。
壹芯微科技针对二三极管,MOS管作出了良好的性能测试,应用各大领域,如果您有遇到什么需要帮助解决的,可以点击右边的工程师,或者点击销售经理给您精准的报价以及产品介绍
工厂地址:安徽省六安市金寨产业园区
深圳办事处地址:深圳市福田区宝华大厦A1428
中山办事处地址:中山市古镇长安灯饰配件城C栋11卡
杭州办事处:杭州市西湖区文三西路118号杭州电子商务大厦6层B座
电话:13534146615
企业QQ:2881579535

深圳市壹芯微科技有限公司 版权所有 | 备案号:粤ICP备2020121154号