 来源:壹芯微 发布日期
2019-10-31 浏览:-
来源:壹芯微 发布日期
2019-10-31 浏览:-高电子迁移率晶体管(HEMT,High Electron Mobility Transistor) :
HEMT是一种异质结场效应晶体管(HFET),又称为调制掺杂场效应晶体管(MODFET)、二维电子气场效应晶体管(2-DEGFET)、选择掺杂异质结晶体管 (SDHT)等。这种器件及其集成电路都能够工作于超高频(毫米波)、超高速领域,原因就在于它采用了异质结及其中的具有很高迁移率的所谓二维电子气来工作的。
上世纪70年代采用MBE 和MOCVD就制备出了异质结。1978年Dingle等首先证实了在AlGaAs/GaAs调制掺杂异质结中存在高迁移率二维电子气;然后于1980年,Mimura等、以及Delagebeaudeuf等研制出了HEMT。从此HEMT就很快地发展起来了,有可能在高速电路领域内替代MESFET。
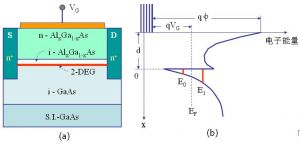
HEMT的原理结构和能带图
(1)FET-IC实现超高频、超高速的困难(提高载流子迁移率的重要性)
因为一般的场效应集成电路为了达到超高频、超高速,必须要减短信号传输的延迟时间τd ∝ CL/(μnVm)和减小器件的开关能量(使IC不致因发热而损坏)E = ( Pd τd )≈CLVm2/2,而这些要求在对逻辑电压摆幅Vm的选取上是矛盾的,因此难以实现超高频、超高速。
解决此矛盾的一个办法就是,首先适当降低逻辑电压摆幅, 以适应IC稳定工作的需要,而要缩短τd 则主要是着眼于提高电子的迁移率μn,这就发展出了HEMT。
(2)HEMT的工作原理:
HEMT的基本结构就是一个调制掺杂异质结。在图中示出了AlGaAs/GaAs异质结HEMT的结构和相应的能带图;在宽禁带的AlGaAs层(控制层)中掺有施主杂质,在窄禁带的GaAs层(沟道层)中不掺杂(即为本征层)。
这里AlGaAs/GaAs就是一个调制掺杂异质结,在其界面、本征半导体一边处,就构成一个电子势阱(近似为三角形),势阱中的电子即为高迁移率的二维电子气(2-DEG),因为电子在势阱中不遭受电离杂质散射,则迁移率很高。这种2-DEG不仅迁移率很高,而且在极低温度下也不“冻结”(即不复合,因为电子与杂质中心在空间上是分隔开的),则HEMT有很好的低温性能, 可用于低温研究工作 (如分数量子Hall效应) 中。异质结界面附近的另一层很薄的本征层(i-AlGaAs),是用于避免势阱中2-DEG受到n-AlGaAs中电离杂质中心的影响,以进一步提高迁移率。
HEMT是电压控制器件,栅极电压Vg可控制异质结势阱的深度,则可控制势阱中2-DEG的面密度,从而控制着器件的工作电流。对于GaAs体系的HEMT,通常其中的n-AlxGa1-xAs控制层应该是耗尽的 (厚度一般为数百nm, 掺杂浓度为107~108 /cm3)。若n-AlxGa1-xAs层厚度较大、掺杂浓度又高,则在Vg =0 时就存在有2-DEG, 为耗尽型器件,反之则为增强型器件( Vg=0时Schottky耗尽层即延伸到i-GaAs层内部);但该层如果厚度过大、掺杂浓度过高, 则工作时就不能耗尽, 而且还将出现与S-D并联的漏电电阻。总之,对于HEMT,主要是要控制好宽禁带半导体层——控制层的掺杂浓度和厚度,特别是厚度。
在考虑HEMT中的2-DEG面密度Ns 时,通常只需要考虑异质结势阱中的两个二维子能带( i = 0和1) 即可。2-DEG面电荷密度Ns将受到栅极电压Vg的控制。
(3)HEMT的I-V特性和跨导:
①对于长沟道HEMT:
其中电子的漂移速度vd不饱和,而且与沟道电场E(y)有关,即有 vd= μE(y) 。则通过宽度是W的沟道的电流为IDS = q W Ns(y) μE(y)= Wμ[ε’ε0 / (d +Δd )]·[Vgs-VT-V(y)]·(dV(y)/dy), 从源端积分到漏端( y = 0→L ), 就得到HEMT的I-V特性:
Ids = μ(W/L) [ε’εo/(d +Δd )]·[(Vgs-VT)Vds-(Vds2)/2]
相应地可求出HEMT的跨导为gm = μ(W/L) [ε’ε0 / (d +Δd )] Vds∝ Vds 。
当Vds增加到Vdsat = Vgs-VT 时, 沟道夹断, 即得到饱和电流:
Idsat = μ(W/L) [ε’ε0 / 2(d +Δd )] (Vgs-VT)2
饱和时的跨导则为 gm sat = μ(W/L) [ε’ε0 / (d +Δd )] (Vgs-VT) 。
②对于短沟道(L ≈1μm)的HEMT:
漂移速度将饱和为vS,则饱和电流为 IDSat = q Ns0 vS W = vS W [ε’ε0 / (d +Δd )] (Vgs-VT) ∝(Vgs-VT)
并且饱和跨导与电压无关: gm sat = vS W [ε’ε0 / (d +Δd )] 。
实际上, 对很短沟道的HEMT, 往往是高得多的瞬态漂移速度起着决定作用,从而有更高的饱和电流和饱和跨导。
(4)高极性半导体调制掺杂异质结的HEMT:
对于极性很大的半导体异质结,那么情况将有所不同。譬如n+-AlGaN/i-GaN调制掺杂异质结,由于其中的高迁移率2-DEG主要是由材料极化效应而产生出来的,因此,即使在AlGaN控制层中不掺杂,也能够得到大量的2-DEG(可高达1013 cm-2),这时的2-DEG面密度将主要决定于极化效应的强度。 A,8,9,.0..76.kl
壹芯微科技针对二三极管,MOS管作出了良好的性能测试,应用各大领域,如果您有遇到什么需要帮助解决的,可以点击右边的工程师,或者点击销售经理给您精准的报价以及产品介绍
工厂地址:安徽省六安市金寨产业园区
深圳办事处地址:深圳市福田区宝华大厦A1428
中山办事处地址:中山市古镇长安灯饰配件城C栋11卡
杭州办事处:杭州市西湖区文三西路118号杭州电子商务大厦6层B座
电话:13534146615
企业QQ:2881579535

深圳市壹芯微科技有限公司 版权所有 | 备案号:粤ICP备2020121154号